Spectrum Ellipsometer FE-5000/5000S
|
|
Automatic angle adjusting mechanism in addition to the basic spectrum ellipsometry system enables high accurate film thickness measurement for variety of thicknesses. Detachable retarder and rotating analyzer also widens the scope of choices available to measure as well as improves the measurement accuracy.
Are you interested in alliance or distributorship for this product? |
- Product
- Principle
- Specification
- Configuration
- Measured Data
Product
- Ellipsometry measurement for both visible and ultraviolet-ray range (250-800nm)
- Nano-order thin film thickness
- Quick measurement using multi channel spectroscopy (over 400ch)
- Angle adjustable mechanism for detailed analysis
- High operability with optical constant database and recipe registration function
- Optical constant measurement using multi layer fitting analysis for quality control of film thickness and film property
- Ellipso-parameters (tanψ、cosΔ)
- Optical constant analysis (n : reflactive index , k : extinction coefficient )
- Thickness analysis
- Semiconductor wafer
Gate oxide thin film, nitride film
SiO2,SixOy,SiN,SiON,SiNx,Al2O3,SiNxOy,poly-Si,ZnSe, BPSG,TiN
Optical constant of resist at each wavelength - Compound semiconductor
AlxGa(1-x)As multilayer film,amorphous silicon - FPD (flat panel display)
Oriented film
ITO, MgO for plasma display - New materials
DLC(Diamond Like Carbon),superconducting thin film,magnetic head thin film - Optical thin films
TiO2,SiO2,multilayer film,antireflection film,reflection film - Lithography
Optical constant for g ray(436nm),h ray(405nm),i ray(365nm),KrF(248nm)
Optical constant of resist at each wavelength
Principle
Ellipsometry measures change of polarization upon reflection light (elliptically polarized) when linear polarized light is irradiated to the sample. As s and p wave changes its phases and reflection amplitudes individually depending on the sample, amplitude ratio “tanψ” and phase difference “cosΔ” which quantify the polarization change can be obtained .
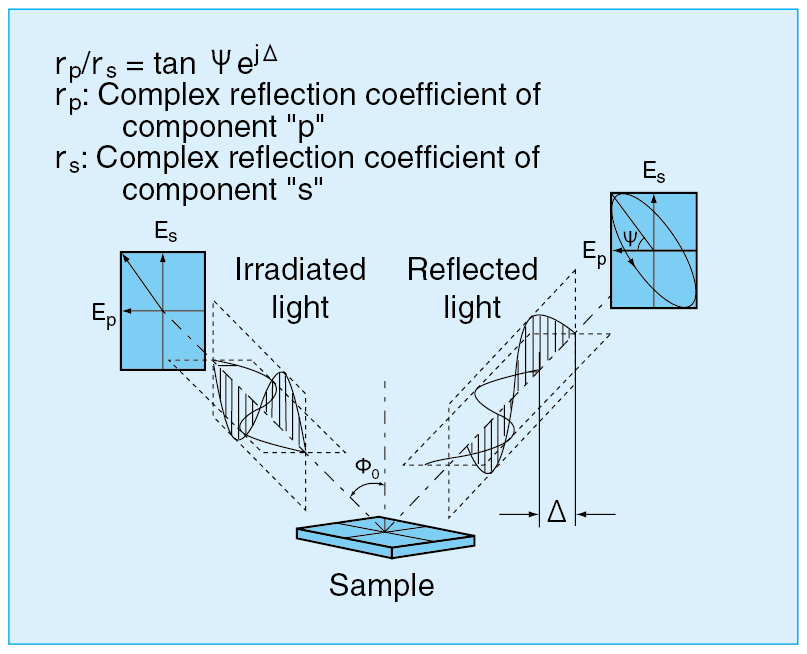
tanψ, cosΔ is called “Ellipso-parameter” and the spectrum of these are measured in Spectrum Ellipsometry.
Specification
| Model | FE-5000S | FE-5000 |
| Measurement sample | Reflective sample | |
| Sample size | 100x100mm | 100x100mm |
| Principle | Rotating analyzer method *1 | |
| Thickness range (nd) | 0.1nm~ | |
| Irradiate(reflect) angle | 45~90° | 45~90° |
| Irradiate(reflect) angle drive method | Automatic sine- bar drive | |
| Spot size*2 | Approx.φ2.0 | Approx.φ1.2*3 |
| tanψ accuracy | < ±0.01 | |
| cosΔ accuracy | < ±0.01 | |
| Reproducibility | < 0.01% *4 | |
| Wavelength range*5 | 300~800nm | 250~800nm |
| Detector | Polychrometer (PDA, CCD) | |
| Light source | High stability xenon lamp *6 | |
| Stage drive | Manual | Manual/Auto |
| Loader | NG | OK |
| Size, weight | 650(W)×400(D)×560(H)mm Approx. 50kg |
1300(W)×900(D)×1750(H)mm Approx. 350kg*7 |
| Software | ||
| Analysis | Least squares thin film analysis(Reflective index model function、Cauchy dispersion model、nk-Cauchy dispersion model) Theoretical analysis(Bulk surface analysis (n.k.), simultaneous analysis of Angle-dependance |
|
*1 Rotating polarizer, detachable retarder
*2 Vary by measuring condition
*3 Microspot available (optional)
*4 Measured in VLSI standard Sio 2 (100nm)
*5 Measurable range
*6 Vary depends on the measuring wavelength
*7 automatic stage
Configuration

Measured Data
ITO (indium-tin-oxide) is the transparent electrode material that is used for flat display like a LCD display. The electrical conductivity and color hue of ITO are improved by annealing treatment (heat treatment) after its film formation. At that time, the oxygen state and the crystalline state of ITO will change. This change tends to gain the slope change in stages with respect to film thickness and it does not become a single layer with uniform composition optically. We’d like to introduce a case of the measurement of degree of inclination of both upper and lower surface’s nk with using the gradient model.
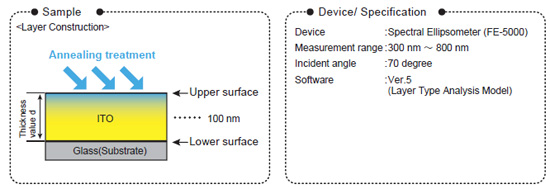
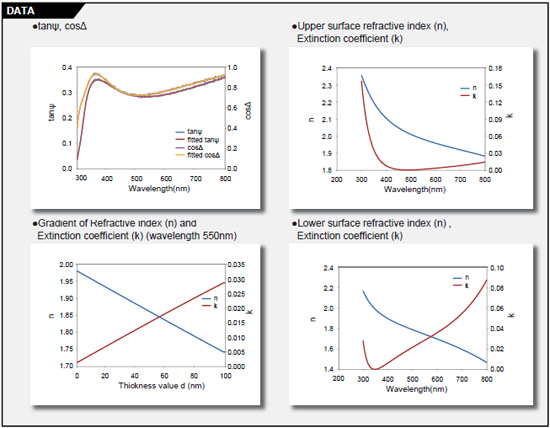
- Product
- Principle
- Specification
- Configuration
- Measured Data


 Close
Close





